

日前,武漢新芯對外宣布稱,基于其三維集成技術平臺的三片晶圓堆疊技術研發成功。該消息一出就有業內人士表示,隨著這一技術的突破,武漢新芯3D芯片堆疊技術居于國際先進、國內領先的水平。
還有業內人士指出,3D芯片堆疊是新的技術,可將存儲、邏輯、傳感器于一體,能夠縮小尺寸且提供性能,是朝摩爾定律的方向邁進了一步。那么問題來了,3D芯片堆疊技術到底是什么?
3D芯片堆疊技術發展歷程
上世紀九十年代,BGA封裝(球柵陣列封裝)替代了外引腳封裝,焊料球凸點面陣使封裝尺寸減小,輸入和輸出端口數量增加,功能和性能增加。然而隨著封裝技術的發展,在平面方向上的封裝已經達到了極限。
另一方面,隨著CMOS工藝的不斷發展,繼續等比例縮小的局限越發明顯,系統設計師們開始越來越多地轉向芯片封裝,而不是繼續依賴在單一芯片上集成更多的器件來提高性能。
在傳統的集成電路技術中,作為互連層的多層金屬位于2D有源電路上方,互連的基本挑戰是全局互連的延遲,特別隨著等比例縮小的持續進行,器件密度不斷增加,延遲問題就更為突出。
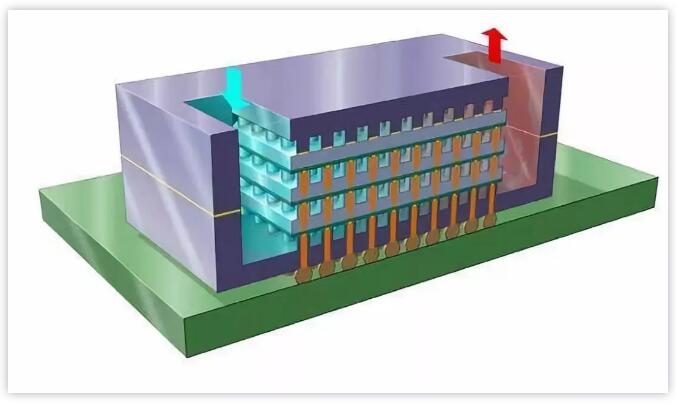
為了避免這種延遲,同時也為了滿足性能、頻寬和功耗的要求,設計人員開發出在垂直方向上將芯片疊層的新技術,也就是三維堆疊封裝技術,該技術可以穿過有源電路直接實現高效互連。
另外一些組織和公司也都在積極開發基于TSV(硅通孔,through silicon via)的3D芯片技術。究其原因,是因為許多芯片廠商都擔心將來繼續縮減制程尺寸時,所花費的成本難以承受,甚至不久的將來可能會被迫停止芯片制程縮減方面的開發。
隨著硅片減薄技術的成功使用,多芯片堆疊封裝的厚度幾乎與過去BGA封裝具有相同的厚度(約1.2毫米)。因此,3D芯片堆疊技術在縮小芯片尺寸的同時,還能有效地增強電子產品的功能和性能。
3D芯片堆疊技術簡介
與傳統的二維芯片把所有的模塊放在平面層相比,三維芯片允許多層堆疊,而過TSV用來提供多個晶片垂直方向的通信。其中,TSV是3D芯片堆疊技術的關鍵。
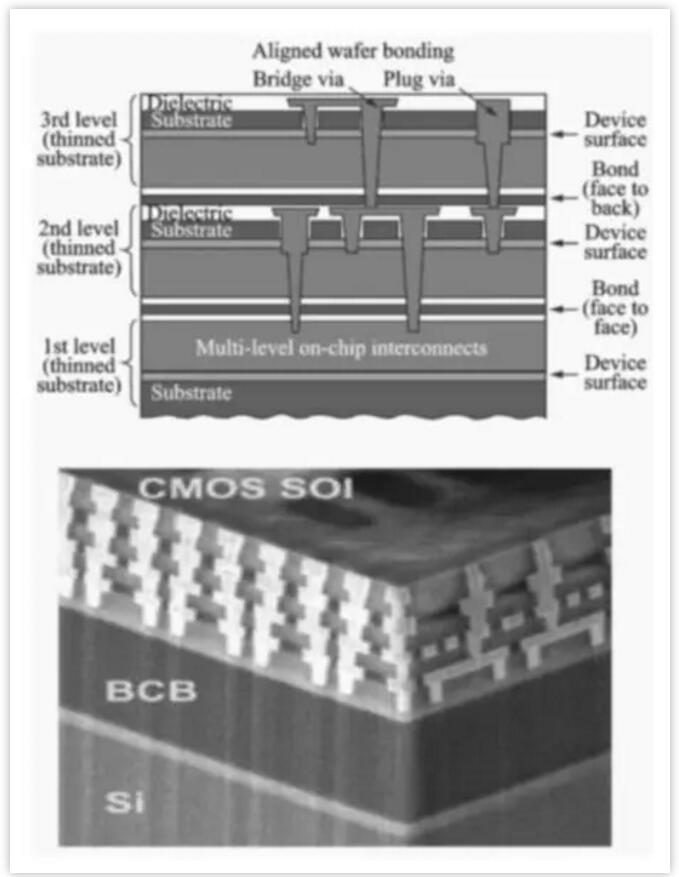
3D芯片堆疊結構示意圖
3D堆疊技術是把不同功能的芯片或結構,通過堆疊技術或過孔互連等微機械加工技術,使其在Z軸方向上形成立體集成、信號連通及圓片級、芯片級、硅帽封裝等封裝和可靠性技術為目標的三維立體堆疊加工技術。該技術用于微系統集成,是繼片上系統(SOC)、多芯片模塊(MCM)之后發展起來的系統級封裝的先進制造技術。
3D芯片技術的類別
從SiP系統級封裝的傳統意義上來講,凡是有芯片堆疊的都可以稱之為3D,因為在Z軸上有了功能和信號的延伸,無論此堆疊是位于IC內部還是IC外部。但是,隨著技術的發展,3D芯片技術卻有了其更新、更獨特的含義。
3D IC的初期型態,目前仍廣泛應用于SiP領域,是將功能相同的裸芯片從下至上堆在一起,形成3D堆疊,再由兩側的鍵合線連接,最后以系統級封裝(System-in-Package,SiP)的外觀呈現。堆疊的方式可為金字塔形、懸臂形、并排堆疊等多種方式,參看下圖。

另一種常見的方式是將一顆倒裝焊(flip-chip)裸芯片安裝在SiP基板上,另外一顆裸芯片以鍵合的方式安裝在其上方,如下圖所示,這種3D解決方案在手機中比較常用。
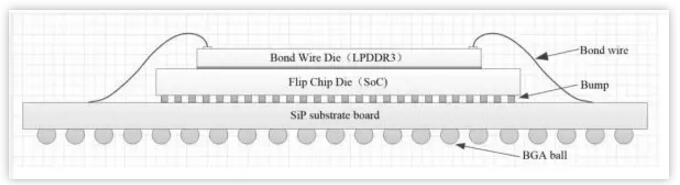
在這種3D集成技術中,至少有一顆裸芯片與另一顆裸芯片疊放在一起,下方的那顆裸芯片是采用TSV技術,通過TSV讓上方的裸芯片與下方裸芯片、SiP基板通訊。如下圖所示:
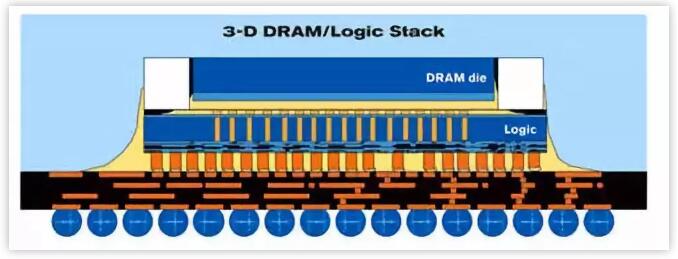
下圖顯示了無源TSV和有源TSV分別對應的2.5D和3D技術。
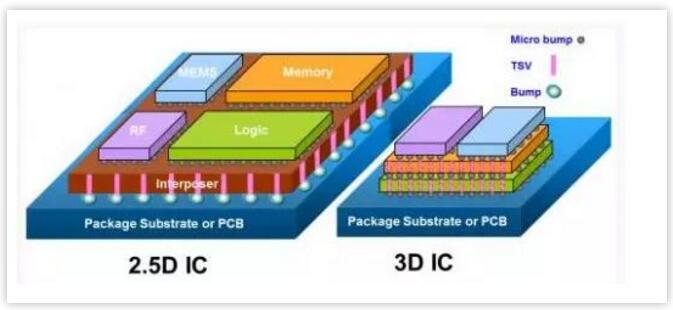
以上的技術都是指在芯片工藝制作完成后,再進行堆疊形成3D,其實并不能稱為真正的3D IC 技術。這些手段基本都是在封裝階段進行,我們可以稱之為3D集成、3D封裝或者3D SiP技術。
在SiP基板與裸芯片之間放置一個中介層(interposer)硅基板,中介層具備硅通孔(TSV),通過TSV連結硅基板上方與下方表面的金屬層。有人將這種技術稱為2.5D,因為作為中介層的硅基板是無源被動元件,TSV硅通孔并沒有打在芯片本身上。如下圖所示:
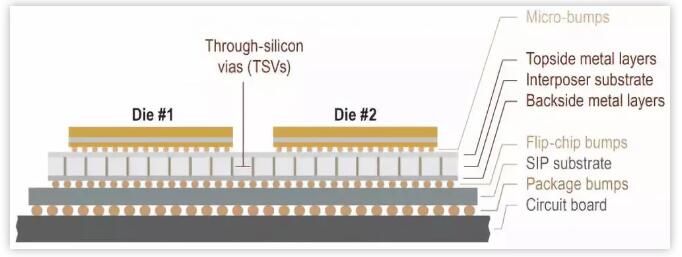

目前,基于芯片制造的3D技術主要應用于3D NAND FLASH上。東芝和三星在 3D NAND 上的開拓性工作帶來了兩大主要的 3D NAND 技術。
東芝開發了 Bit Cost Scalable(BiCS)的工藝。BiCS 工藝采用了一種先柵極方法(gate-first approach),這是通過交替沉積氧化物(SiO)層和多晶硅(pSi)層實現的。然后在這個層堆疊中形成一個通道孔,并填充氧化物-氮化物-氧化物(ONO)和 pSi。然后沉積光刻膠,通過一個連續的蝕刻流程,光刻膠修整并蝕刻出一個階梯,形成互連。最后再蝕刻出一個槽并填充氧化物。如下圖所示:

三星則開發了 Terabit Cell Array Transistor (TCAT)工藝。TCAT 是一種后柵極方法( gate-last approach),其沉積的是交替的氧化物和氮化物層。然后形成一個穿過這些層的通道并填充 ONO 和 pSi。然后與 BiCS 工藝類似形成階梯。最后,蝕刻一個穿過這些層的槽并去除其中的氮化物,然后沉積氧化鋁(AlO)、氮化鈦(TiN)和鎢(W)又對其進行回蝕(etch back),最后用塢填充這個槽。如下圖所示:
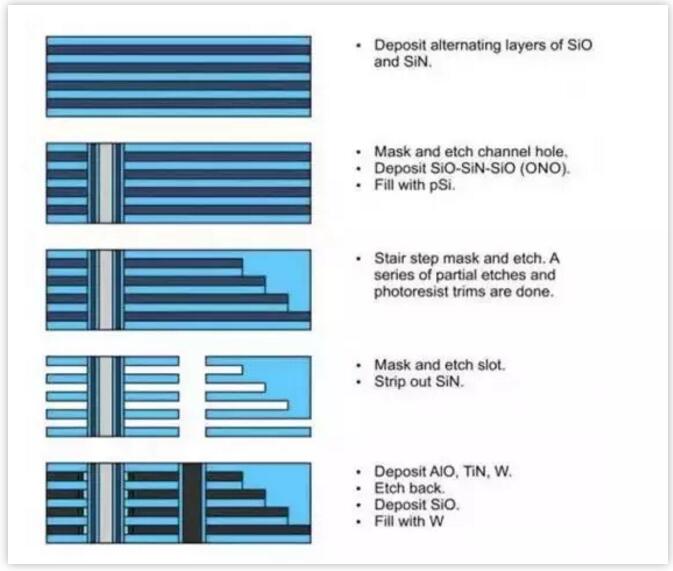
3D NAND目前已經能做到64層甚至更高,其產量正在超越 2D NAND,而且隨著層數的進一步擴展,3D NAND還能繼續將摩爾定律很好地延續。
TSV——層間互連技術
上文提到,在3D芯片堆疊技術當中,TSV是其關鍵,那TSV到底又是什么呢?
TSV(through silicon via),中文為硅通孔。TSV通過再芯片與芯片之間、晶圓與晶圓之間制作垂直導通,實現芯片之間互連,能夠使三維方向堆疊的密度最大,外形尺寸最小,并且大大改善芯片速度和降低功耗。
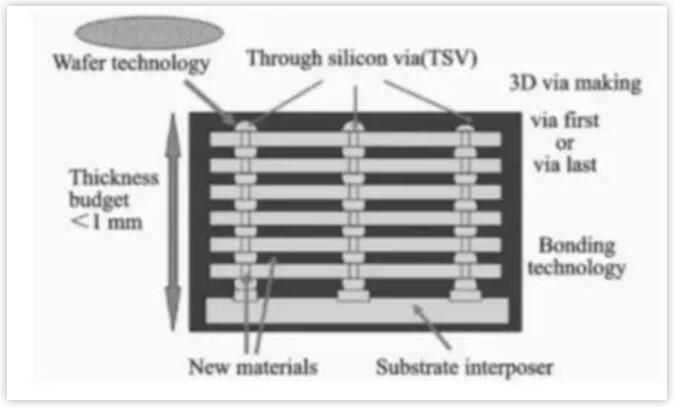
采用TSV技術堆疊的器件
TSV與目前應用于多層互連的通孔有所不同。一方面,TSV通孔的直徑通常僅為1-100Lm(光通量的物理單位),深度10-400Lm,為集成電路或其他多功能器件高密度混合集成提供可能;另一方面,它們不僅需要穿透組成疊層電路的各種材料,還需要穿透很厚的硅襯底,因此對通孔的刻蝕機技術具有較高的要求。

3D TSV互連概念模型
上圖是一個3D TSV互連的概念模型,TSV是利用垂直硅通孔完成芯片互連的方法,由于連接距離更短、強度更高,它能實現更薄更小而性能更好、密度更高、尺寸和重量明顯減小的封裝。同時還能用于異種芯片之間的互連。

根據通孔制作的時間不同,3D TSV通孔集成方式可以分為四類:
1.先通孔工藝,即在CMOS制程之前完成硅通孔制作。先通孔工藝中的盲孔需電鍍絕緣層并填充導電材料,通過硅晶圓減薄,使盲孔開口形成與背面的連接。
2.中通孔工藝,即在CMOS制程和后段制程(BEOL)之間制作通孔。
3.后通孔工藝,即在BEOL完成之后再制作通孔,由于先進行芯片減薄,通孔制成后即可與電路相連。
4.鍵合后通工藝,即在硅片減薄、劃片之后再制作TSV。
圓片上通孔制造是TSV技術的核心,目前,鉆蝕TSV技術主要有兩種,一種是干法刻蝕或稱博世刻蝕,另一種是激光刻蝕。博世工藝為MEMS工藝而開發,快速地在去除硅的SF6等離子刻蝕和實現側壁鈍化的C4F8等離子沉積步驟之間循環切換。下圖為南京電子器件所(NEDI)利用博世工藝制作的TSV硅通孔。

NEDI研制的3D TSV通孔
激光技術作為一種不需掩膜的工藝,避免了光刻膠涂布、布刻曝光、顯影和去膠等工藝步驟,三星在存儲器疊層中采用了這一技術。激光加工系統供應商Xsil公司(愛爾蘭)為TSV帶來了另一種解決方案,Xsil稱激光鉆孔工藝首先應用到低密度閃存及CMOS傳感器中,隨著工藝及生產能力的提高,將會應用到DRAM中。
TSV被許多半導體廠和研究機構認為是最有前途的封裝方法,世界上50%以上的廠商都參與3D TSV互連相關方面的研究。其中,以三星,SK海力士等為首的企業在積極推廣可將3D TSV的計劃。此外,英特爾、臺積電、格芯、高通、安森美、惠普、IBM、聯電、紐約州立大學等都有在研究3D芯片堆疊技術。
3D芯片堆疊技術應用及行業影響
如今,3D芯片堆疊技術在一些設備中已經有總領性的作用。從第一代開始,Apple Watch就是由最先進的3D堆疊式芯片封裝之一驅動。在該智能手表中,30種不同的芯片密封在一個塑料包層里面。為了節省空間,存儲芯片堆疊在邏輯電路上面。如果沒有采用芯片堆疊技術,該手表的設計就無法做到如此緊湊。
英偉達硬件工程高級副總裁布萊恩·凱萊赫表示,公司針對AI打造的Volta微處理器的運作也運用了3D堆疊技術。通過直接在GPU上面堆疊八層的高頻寬存儲器,這些芯片在處理效率上創造了新的記錄。“我們在電力上是受限的,我們能夠從存儲系統騰出的任何電力,都可以用在計算上。”凱萊赫如是說。
芯片堆疊也帶來了一些全新的功能。有的手機攝像頭將圖像傳感器直接疊加在處理圖像的芯片上面,額外的速度意味著它們能夠對照片進行多次曝光,并將其融合在一起,在昏暗的場景里捕捉到更多的光線。
由此可見,3D芯片堆疊技術的應用市場非常大,一旦全面投入市場,將極大的提升計算機芯片性能。可以說,3D芯片堆疊技術是一個趨勢和必然,日后會越來越普通。
結語:
半導體業晶圓制程即將達到瓶頸,也就代表摩爾定律可能將失效。在晶圓制程無法繼續微縮下,封測業將暫時以系統級封裝等技術將芯片做有效整合,提高芯片制造利潤,挑起超越摩爾定律的角色。
中國臺灣半導體協會理事長盧超群指出,未來半導體將要做3D垂直堆疊,全球半導體產業未來會朝向類摩爾定律成長。封測業人士指出,目前不論是在邏輯芯片上抑或是NAND Flash上,都需要3D堆疊技術,才能讓芯片效益發揮最大化,也才能達到輕薄短小的程度。從這一點上看,武漢新芯基于其三維集成技術平臺的三片晶圓堆疊技術研發成功,確實代表了芯片未來方向。